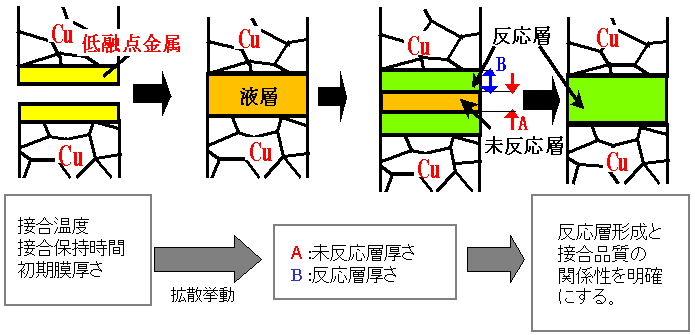
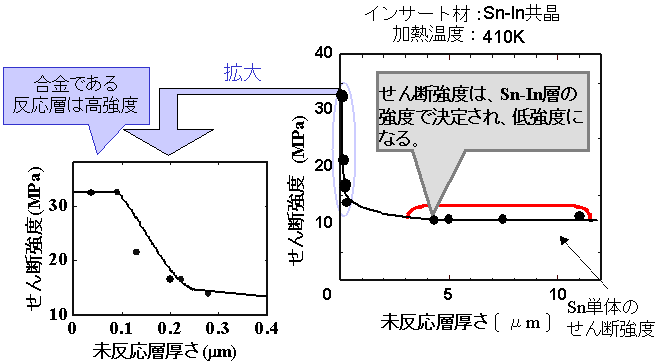
近年,小型高密度化が要求されています.
また,耐高温特性の良好なはんだ材がありません.
これら二つの要求を満たす接合体の形成を目的としています.
低融点金属をインサート材に用いた拡散接合により低温実装が可能で,
低融点金属と母材金属の拡散反応は不可逆反応なので再溶融が起こらず,
高温での使用に耐えられます.
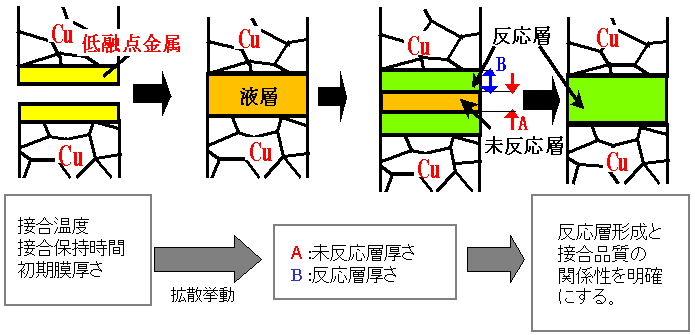
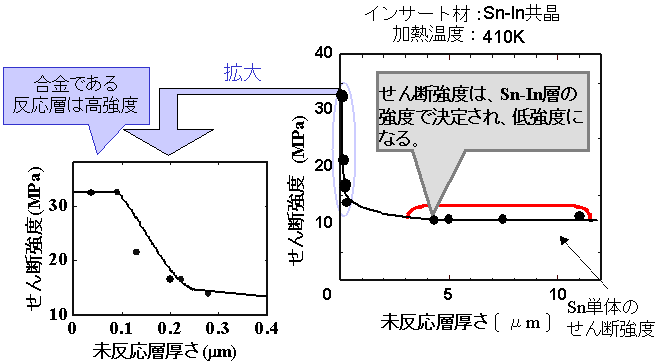
銅金属を接合する母材とし,その間に低融点金属であるSnIn共晶(融点118℃)を インサート材として挿入し,加圧・加熱をして完全に拡散・反応させて接合を行います(上図).
下図は拡散・反応を起こして合金化すると,高強度になることを示しています.
マイクロ接合においては,熱の影響による変形が接合時の問題となりますが, 低温接合ですのでマイクロ接合に使用出来ます. 通常のはんだ接合では,高温になると接合部ではんだが再溶融し接合不良を発生しますが, 高温になっても拡散反応が進むだけで,再溶融しない拡散接合は高温環境での使用を可能とします.